 题目内容
(请给出正确答案)
题目内容
(请给出正确答案)
[主观题]
STI隔离技术中,为什么采用干法离子刻蚀形成槽?
提问人:网友aaa278924248
发布时间:2022-01-06
 题目内容
(请给出正确答案)
题目内容
(请给出正确答案)
 更多“STI隔离技术中,为什么采用干法离子刻蚀形成槽?”相关的问题
更多“STI隔离技术中,为什么采用干法离子刻蚀形成槽?”相关的问题
1.给出每一步的具体工艺方法和需要用到的设备:不能写PVD,必须给出具体PVD中的哪种工艺及相应的设备; 2.采用这种工艺方法的原因;光刻必须给出光刻胶正负,画出掩模板图形 3.作图给出每一步完成之后得到的结构; 4.画出完整的工艺流程图; 5. 不需要给出具体工艺控制参数的值,如温度、压力等的具体数值,但工艺方法、原理必须描述清楚、详尽; 6. 论述制备过程中的以下关键技术问题: (1) MOS隔离技术的可选工艺有哪些? (2) 什么是STI?STI氧化物填充过程中发生了哪些氧化反应步骤,分别写出反应方程,氧化反应特点及作用? (3) STI槽刻蚀的工艺步骤,并阐述氮化硅和氧化硅的作用? (4) 什么是短沟道效应?采用那些措施防止?叙述具体工艺步骤 (5) n阱形成的工艺步骤及各关键步骤的作用? p阱注入和n阱注入时的差别? (6) 哪些工艺步骤中不需要掩膜?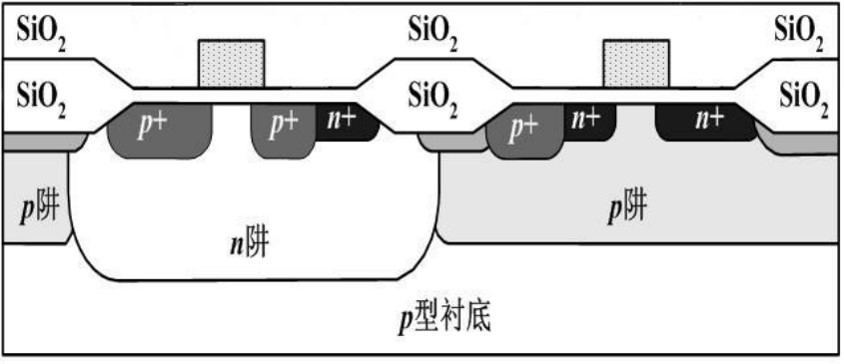


为了保护您的账号安全,请在“简答题”公众号进行验证,点击“官网服务”-“账号验证”后输入验证码“”完成验证,验证成功后方可继续查看答案!

 微信搜一搜
微信搜一搜
 简答题
简答题



 微信搜一搜
微信搜一搜
 简答题
简答题